Introduction
Ceramic substrate warpage is the invisible killer in the power module packaging process. Once warpage occurs, subsequent chip mounting and wire bonding stages are bound to encounter serious problems.
A series of failures, such as solder joint voids, chip cracking, and broken bonding wires, will occur one after another. This phenomenon is the result of the combined effects of multiple factors, including materials, structure, and processes.
This article will delve into the mechanism of ceramic substrate warpage, analyze the root causes of its influencing factors, and provide end-to-end control methods from design to production, offering practical reference for technical personnel engaged in power module packaging.

What Is Warpage, and What Effects Does it Have on Ceramic Substrates?
Ceramic substrate warpage refers to non-planar deformation that occurs during the manufacturing or subsequent processing of a ceramic substrate, typically manifesting as bulges, dents, or twists.

Now that we understand the issue of warpage in ceramic substrates, let’s take a look at exactly how warpage affects ceramic substrates.
The table below summarizes the specific impacts and typical consequences observed in certain process stages.
| Impact | Typical Consequences |
| Poor chip mounting | Voids in the solder layer, tilted chips, and component detachment |
| Difficulty in wire bonding | Uneven bonding force, warped leads, and microcracks at the bonding points |
| Decreased heat dissipation efficiency | Increased interfacial thermal resistance, reducing heat dissipation efficiency |
| Module assembly failure | Poor contact with the heat sink, resulting in increased contact thermal resistance |
| Decreased long-term reliability | Stress concentration under thermal cycling, accelerating failure |
Once these issues arise, they can affect yield rates, and in severe cases, result in the entire batch of substrates being scrapped. To avoid this, it is essential to first understand why ceramic substrates warp.
Why Do Ceramic Substrates Warp?
Material Internal Stress
Uneven particle size distribution or insufficient purity of ceramic powder can lead to a porous internal structure of the ceramic substrate, making it prone to warping due to stress concentration during sintering.
Alternatively, a mismatch in the thermal expansion coefficients of the metallization layer and the ceramic layer can cause different expansion or contraction rates with temperature changes, resulting in interlayer shear stress.
Furthermore, the thicker the metallization layer and the thinner the ceramic, the more exponentially this interfacial stress is amplified.
Improper addition of sintering aids can widen the sintering temperature range, leading to uneven grain growth within the ceramic substrate and consequently internal stress, causing warping.
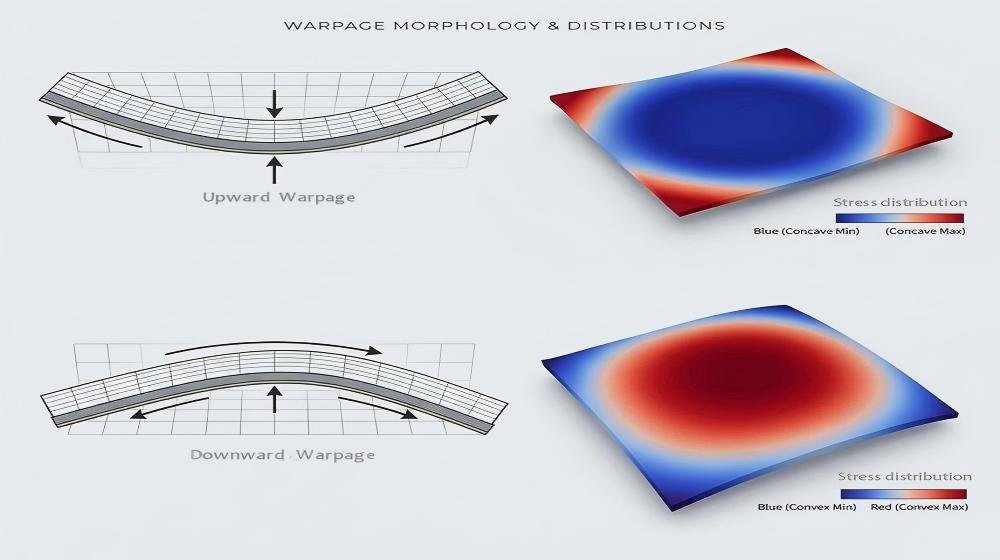
Process Defects
Excessively rapid heating and cooling rates during sintering can create a large temperature difference between the ceramic substrate surface and interior, preventing timely release of thermal stress.
Uneven sintering atmospheres can also cause variations in the degree of oxidation or reduction reactions, further contributing to warping.
Uneven pressure during the forming stage can also have adverse effects: for example, during tape casting, improper control of the solid content and viscosity of the slurry can lead to inconsistent film thickness, resulting in stress due to density differences after sintering.
Similarly, insufficient pressure during isostatic pressing can also cause uneven density in different parts of the ceramic substrate.
Environmental Factors
Power modules often operate in harsh environments with high temperature, high frequency, and high power. Long-term temperature cycling (e.g., -40℃ to 150℃) can cause repeated accumulation of residual stress inside the ceramic substrate, gradually exacerbating warping deformation.
Simultaneously, environmental humidity, vibration, and other factors can also accelerate the warping trend and even cause secondary damage.
Methods for Controlling Ceramic Substrate Warpage
Having understood the effects and causes of ceramic substrate warpage, how can it be effectively controlled in actual production?
Based on our production and engineering practice, warpage control needs to be integrated across four stages: design, materials, process, and verification. None of these can be omitted.
Design Phase: Symmetrical Layout and Thickness Matching
The root of warping problems often lies in the design phase. The key control point in the design process is structural symmetry.
Common design elements can be referred to in the table below:
| Design Elements | Control Principles | Engineering Suggestions |
| Metallization Rate | The difference in metallization rate between the front and back sides should be controlled within 30%. | If a large copper area is required on the front side, add a stress-balancing copper layer for non-electrical connections on the back side. |
| Copper Layer Thickness | The thickness of the copper layer on one side should not exceed 15% of the ceramic thickness. | For high current carrying capacity requirements, prioritize increasing the copper layer area rather than its thickness, or use symmetrical thickening. |
| Ceramic Thickness | The thinner the ceramic substrate, the greater the risk of warpage. | Ceramic substrates thinner than 0.32mm require special assessment of warpage risk. |
| Graphic Layout | Avoid large areas of copper layer concentration on one side. | Below the chip mounting area, maintain symmetry in the structure of the front and back sides of the substrate as much as possible. |
In our actual projects, we’ve found that many warping problems are “manufactured,” but even more so, “designed.” Small details in the design phase often prove crucial.

Materials Stage: Controlling Internal Stress from the Source
Design is only the first step; optimizing and controlling the materials is equally crucial. The core of material control is ensuring the quality stability of the ceramic substrate itself and the compatibility of the metallization layer.
Optimizing Ceramic Powder and Formulation
Select ceramic powders with uniform particle size distribution and high purity. By adjusting the particle size distribution, the density and thermal stability of the substrate are improved.
Simultaneously, the material formulation is optimized, and sintering aids are added appropriately. The amount of aids added must match the powder to avoid an excessively wide sintering window, lower the sintering temperature, and reduce internal stress caused by high temperatures.
Selecting Suitable Metallization Layer Materials
In the preparation of the metallization layer on the ceramic substrate, we should select a metal material (such as Cu, Mo, etc.) matching the coefficient of thermal expansion of the ceramic based on the application.
Alternatively, the thickness of the metallization layer can be adjusted to reduce stress caused by differences in thermal expansion. This ensures controllable stress in the plating layer and meets adhesion standards.
In short, the inherent properties of ceramic substrates are determined at the material stage. If the powder quality is substandard, even the most sophisticated subsequent processes cannot compensate for it.
For material selection guidance, please refer to: Al₂O₃ vs AlN vs Si₃N₄: Which Is Best for Power Modules?
Manufacturing Process: Stress Relief and Process Control
The manufacturing process of ceramic substrates is inherently a process of “stress accumulation.” With each thermal cycle, the internal stress builds up. Therefore, process control at each stage is crucial.
The table below summarizes the key control points for critical process nodes:
| Process Nodes | Control Methods | Verification Indicators | Key Points |
| Heating/cooling during sintering | Pressure sintering + slow cooling curve (cooling rate of 2~5℃/min in the high-temperature section) | Warpage after sintering <50㎛ | Rapid cooling is more fatal than rapid heating.
A reasonable cooling rate can prevent excessive temperature differences between the surface and interior, reducing thermal stress. |
| Electroplating | Electroplating layer stress monitoring + medium-temperature annealing (250~300℃, 1~2h) | Warpage improvement rate before and after annealing > 60% | Annealing is the most cost-effective stress-relieving method. |
| Leveling | Mechanical/laser leveling | Warpage after leveling < 30㎛ | For high-precision applications (such as optical modules and LiDAR), leveling is a necessary process. |
| Before shipment | 100% 3D warp scanning | Shipped by grade according to customer specifications | The consistency of warpage is more important than its absolute value. |
Post-Process Inspection and Verification
Rigorous Inspection and Screening
Establish a comprehensive inspection system, employing equipment such as laser flatness testers or feeler gauges to accurately detect the warpage of ceramic substrates.
Substrates with warpage exceeding the standard will be screened out to prevent them from entering subsequent processes.
Warpage Correction
For substrates with slight warpage, annealing can be used to release residual stress and restore flatness.
Mechanical correction can also be used, but we must take care to control the correction force to avoid substrate cracking.

Of course, warpage data at room temperature is only for reference. What truly has engineering significance is the substrate’s performance under “the customer’s actual process conditions.”
It is recommended to complete the following three verifications during the sample stage:
Reflow Soldering Simulation: The ceramic substrate is subjected to one reflow soldering cycle under no-load conditions at a peak temperature of 245~260℃.
The warpage rate before and after reflow soldering is tested. The passing standard is a warpage rate of less than 20%. This verification simulates the customer’s surface mount technology (SMT) process.
The core purpose is to confirm whether the residual stress inside the substrate has been fully released. Many substrates pass at room temperature but warp after reflow soldering, and this is the reason.
Thermal Cycling Test: 500 cycles are performed within a temperature range of -40℃ to 125℃. After the test, the warpage should be less than 30㎛, and there should be no cracks.
This verification simulates the stress accumulation effect under long-term operating conditions, which is particularly important for scenarios requiring long-term stable operation, such as new energy vehicles and photovoltaic inverters.
SMT Matching: The ceramic substrate is placed on an actual SMT machine for verification. The rejection rate should be less than 0.5%, and the solder void rate less than 1%.
This is the final “real-world” verification—no matter how good the previous data looks, it’s not as effective as running it on the machine.
The SMT machine’s requirement for substrate coplanarity is the most direct. If this criterion isn’t met, all previous efforts are in vain.
Common Misconceptions and Suggestions Regarding Warpage Issues
Based on our project experience, there are several common misconceptions engineers often fall into. These are summarized here for your reference:
| Common Misconceptions | Incorrect Practices | More Reasonable Approach |
| Focusing only on materials, ignoring structure | Simply replacing the material with one that has better thermal conductivity will solve the warping problem. | First check the structural symmetry, then consider material optimization. |
| Measuring only room temperature, ignoring high temperature | Testing flatness at room temperature and releasing the product. | It is essential to measure “post-reflow warpage” and “post-thermal cycling warpage,” as these two indicators are more meaningful for engineering purposes than room temperature values. |
| Choosing only the most expensive, not the right one | Directly choosing Si₃N₄+AMB, believing it to be the safest option. | For low-to-medium power applications, Al₂O₃ + DBC is perfectly adequate.
Selection should be based on actual operating conditions. |
| Reviewing after the fact, not controlling beforehand | Relying on full inspection before shipment to select qualified products. | Process control capability is more important than testing equipment. Good batch stability is the real skill. |
| Ignoring process details | As long as the final warping is acceptable, the intermediate processes are irrelevant. | The sintering cooling rate and post-electroplating annealing are all intermediate steps that affect the final result.
If the process gets out of control, problems will inevitably arise sooner or later. |
Conclusion
The issue of ceramic substrate warpage is, at its core, a matter of stress control. Every step of the process—from structural design and material selection to process optimization—affects the final degree of warpage.
While there is no such thing as a substrate with absolutely “zero warpage,” effective control measures can keep warpage well within acceptable limits.
For power module packaging, effectively controlling warpage lays a solid foundation for long-term reliability.
Frequently Asked Questions
Q1: What warpage percentage is considered acceptable?
A1: There is no uniform standard. It’s usually calculated as a percentage of the diagonal.
For standard applications, <0.75% is required, while for high-end applications (automotive, optical communication), <0.5%.
It’s important to specify the testing conditions (room temperature or after reflow soldering).
Q2: Will adding a virtual copper layer on the back affect electrical performance?
A2: No. The virtual copper layer is only used to balance stress; it does not connect to circuits or carry current.
During design, simply avoid using it in critical signal areas on the front to prevent unnecessary parasitic capacitance.
Q3: Is it possible to achieve zero warpage?
A3: No. Heterogeneous material composite structures inevitably contain internal stress.
The goal is to make it “controllable,” not to achieve “zero warpage.” That is, to control substrate warpage within the tolerance range of the packaging process.
Q4: Does a thicker ceramic substrate reduce warping?
A4: Not necessarily. Increasing the ceramic substrate thickness from 0.32mm to 0.5mm significantly reduces warping.
Increasing it further to 0.63mm reduces the improvement, but the negative side effects such as decreased thermal conductivity and increased cost become more pronounced.
Therefore, don’t rush to add more thickness. Finding the right balance is key.
Q5: The supplier says “100% testing before shipment,” is that enough?
A5: No, it’s not. Testing is “post-shipment screening,” it only guarantees that this batch of goods is problem-free.
What you should focus on more is the supplier’s process control capabilities. If processes like annealing, sintering curves, and stress monitoring are done well, the product will naturally be stable.




